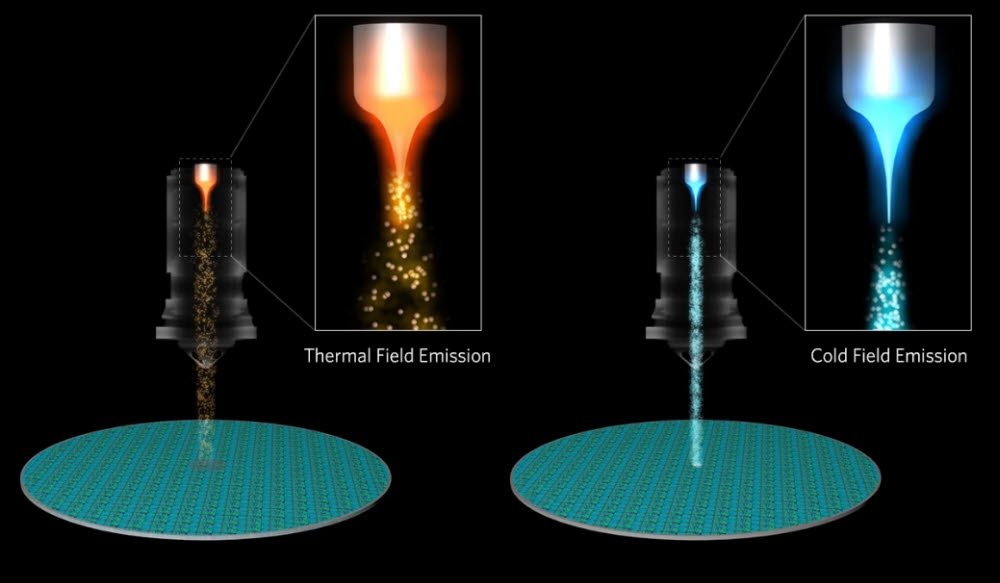
어플라이드머티어리얼즈가 차세대 전자빔 기술 '냉전계방출(CFE)' 기술을 상용화했다. CFE는 나노미터 이하 반도체 초미세 회로의 결함을 파악할 수 있는 것이다. 높은 화질뿐 아니라 계측 속도도 기존보다 10배 빨라 첨단 반도체 개발에 보탬이 될 전망이다.
어플라이드는 CFE 기술을 적용한 반도체 전자빔 계측 장비 2종(SEM비전 G10 결함 리뷰 시스템·프라임비전 10 결함 검출 시스템)을 출시했다고 13일 밝혔다.
전자빔은 광학 시스템(옵틱)과 함께 대표적인 반도체 결함 검출 방식으로 손꼽힌다. '건'이라고 불리는 전자빔 장비 부품에 높은 전압을 걸어 전자를 사출하는데 이 전자가 반도체 웨이퍼에 부딪혀 반사된 것을 분석해 회로 결함 등 이상 유무를 파악한다.
원리는 광학식과 비슷하지만 빛 대신 전자를 이용하는 것이 특징이다. 전자빔은 광학식보다 좁은 영역의 반도체 회로를 검사하고 속도가 느리지만 매우 정확하다는 강점이 있다.


기존 전자빔은 '고온전계방출형(TFE)'이라는 기술을 주로 활용했다. 1500도에 달하는 높은 온도에서 작동 가능한데 고온 영향으로 쏘는 전자 수가 많지 않고 전자빔 조사 영역이 넓어지는 한계가 있다.
CFE는 26도 상온에서 전자를 사출한다. 전자 수가 많고 빔 조사 영역이 좁아, TFE보다 명확한 회로 결함 이미지를 얻을 수 있다. 얼마나 작은 물체를 구분해 볼 수 있는지를 수치화한 '분해능'이 TFE보다 1.5배 뛰어나다. 계측된 이미지를 얻는 속도도 TFE보다 10배 빠르다.
다만 CFE는 장비 안 불순물이 전자 흐름을 방해할 수 있다. 어플라이드는 초고진공 전자빔 부품(컬럼)으로 이 문제를 해결했다고 설명했다. 불순물을 제거하는 자가 세정 기술도 CFE 상용화에 한몫했다고 덧붙였다.

어플라이드는 CFE 기술을 적용한 전자빔 장비로 '게이트올어라운드(GAA)'나 D램·메모리의 3차원(3D) 검사 등 차세대 반도체 계측 시장을 공략할 계획이다. GAA는 핀펫에 이은 차세대 트랜지스터 구조로 회로 간격이 매우 좁고 3D 구조를 갖추고 있다. 이 때문에 최대치로 잡아야 1.5나노미터 안팎까지만 계측할 수 있는 기존 TFE 전자빔으로는 결함 검사에 한계가 있다는 것이 어플라이드 설명이다. CFE는 1나노미터 이하 '옹스트롬(0.1나노미터)' 단위까지 계측 가능하다.
이석우 어플라이드코리아 기술담당 총괄은 “극자외선(EUV) 노광 공정이 늘어나면서 예상치 못한 반도체 초미세 결함이 여럿 발생하고 있다”며 “CFE 기술로 기존에 파악하지 못한 회로 결함을 신속하게 파악할 수 있다”고 강조했다.
권동준기자 djkwon@etnews.com








