
세계 최대 반도체 장비회사인 미국 어플라이드 머티어리얼즈가 '이종집적(HI)' 핵심 장비를 대거 출시했다. 이종집적은 서로 다른 반도체를 결합, 칩 제품 성능을 끌어올리는 것으로 최근 급부상한 고대역폭메모리(HBM) 등 2.5D 및 3D 반도체를 만드는 핵심기술이다.
어플라이드는 △인세프라 SiCN 증착 시스템 △카탈리스트 CMP 솔루션 △프로듀서 인비아 2 CVD 시스템 △엔듀라 벤튜라 2 PVD 시스템 △프로듀서 아빌라 PECVD 시스템 등 반도체 장비 5종을 출시했다고 18일 밝혔다. 모두 하이브리드 본딩과 TSV 최신 기술을 녹여낸 것이 특징이다.
반도체 칩이나 웨이퍼 간 저항이 적은 구리 소재로 연결하는 하이브리드 본딩과 칩에 미세한 구멍을 뚫어 위·아래를 전극으로 연결하는 TSV가 이종집적 핵심 기술이다. 기술 난도가 높아 일부 반도체 제조사만 반도체 제조에 적용하고 있다.
어플라이드의 하이브리드 본딩 신규 장비 중 인세프리아 SiCN은 증착 장비로, 웨이퍼와 웨이퍼를 잇는 구리가 보다 넓은 면적에 안정적으로 결합되도록 실리콘탄소질화물(SiCN)을 사용한다. 카탈리스트 CMP 솔루션은 결합되는 구리 표면 강도를 떨어트리는 '에어갭'을 최소화할 수 있다.
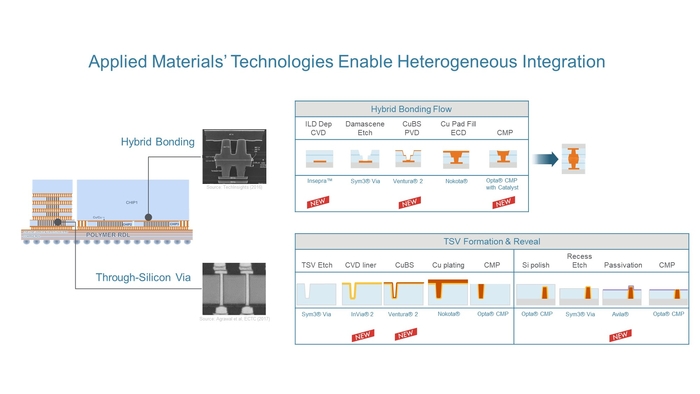
어플라이드는 TSV 분야에서도 신기술로 제품 포트폴리오를 확대했다. 프로듀서 인비아 2 CVD는 특수 증착 기술을 활용해, 원자층증착(ALD)보다 높은 생산성을 제공한다. 웨이퍼 당 TSV 공정 비용을 절감할 수 있다. 엔듀라 벤튜라 2 PVD 시스템과 프로듀서 아빌라 PECVD는 각각 금속 TSV 와이어 증착 제어를 향상시키고 초저온에서 고속으로 TSV 품질을 향상시킬 수 있다.
이번 제품 출시는 2.5D와 3D 반도체 시장 성장에 대응하기 위한 포석으로 풀이된다. 최근 HBM 등 반도체를 수직으로 쌓는 수요가 늘어나면서 하이브리드 본딩과 TSV 장비를 도입하려는 반도체 제조사도 늘었기 떄문이다. 또 시스템 반도체에서도 '칩렛' 등 반도체끼리 연결하는 움직임이 빨라지면서 이종집적을 위한 반도체 장비가 각광받고 있다.
권동준 기자 djkwon@etnews.com









