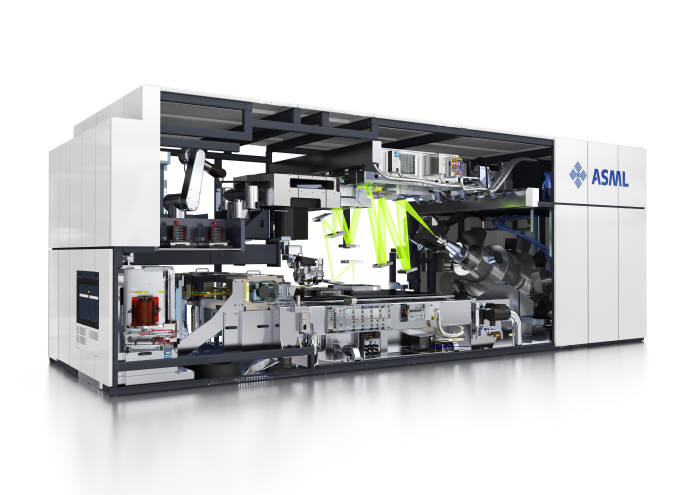
극자외선(EUV) 노광 장비에 쓰이는 마스크 검사 장비 개발도 시급하다. EUV 마스크는 기존 마스크와는 다른 구조다. EUV 장비의 내부 구조 변화에 따른 것이다. 패턴이 미세화 되기 때문에 마스크 검사 기능 역시 업그레이드돼야 한다. 기존의 불화아르곤 액침(immersion) 노광 장비용 마스크 검사 장비는 불화아르곤의 빛 파장과 동일한 193㎚ 광원으로 검사를 진행했다. 이론으로 따지면 EUV 마스크 검사 장비는 EUV의 빛 파장인 13.5㎚ 광원으로 검사를 진행해야 한다. 그러나 KLA-덴코 등은 이러한 장비를 개발하려면 천문학 규모의 연구개발(R&D)비가 들어간다며 난색을 표하고 있는 것으로 전해진다. 설령 장비를 개발했다 하더라도 이를 구매할 업체가 손에 꼽을 정도로 적어서 가격이 높아질 수밖에 없다. 현재 EUV 노광 공정을 수행할 수 있는 곳은 삼성전자, 인텔, TSMC 정도다.
전자빔을 활용해 EUV 마스크를 검사하는 방법도 거론되고 있지만 이 역시 처리 속도가 늦어서 양산 라인에 도입하는 것이 쉽지 않다는 평가다.
마스크를 보호하는 펠리클을 활용할 경우 검사 방법은 더 어려워진다. 당초 업계에선 EUV 펠리클을 사용하지 않으려 했다가 먼지에 따른 결함 발생 가능성이 짙다는 판단을 내리고 다시 개발 작업을 진행하고 있다. 업계 관계자는 26일 “물리력으로 펠리클을 떼어낸 뒤 마스크를 검사할지 펠리클이 얹혀 있는 상태 그대로 검사할지 다양한 옵션이 있지만 양쪽 다 어려운 일”이라고 전했다. 펠리클 투과도를 높이려면 두께가 얇아져야 한다. 펄렁거리는 얇은 펠리클을 물리력으로 떼어냈다가 붙이는 건 고도의 정밀도를 요하는 작업이다. 펠리클이 얹혀 있는 상태에서 곧바로 검사 작업을 할 경우 정확도는 떨어질 수밖에 없다.
또 다른 업계 관계자는 “EUV 노광용 포토레지스트(PR), 마스크 보호용 펠리클에 이어 마스크 검사 장비가 공정 도입의 새로운 걸림돌로 떠오르고 있다”면서 “검사 장비 없이 양산을 수행할 경우 결함에 의한 수율 저하, 이에 따른 칩 원가 상승을 야기하게 될 것”이라고 설명했다.
한주엽 반도체 전문기자 powerusr@etnews.com







